TSV轉(zhuǎn)接板系列

針對(duì)目前 TSV 工藝中的技術(shù)難點(diǎn),蘇州甫一電子科技有限公司采用復(fù)合刻蝕技術(shù)實(shí)現(xiàn)高深寬比結(jié)構(gòu)的微孔制備�����,采用獨(dú)特的薄膜沉積技術(shù)構(gòu)建均勻致密的絕緣層,通過精密電沉積技術(shù)進(jìn)行金屬互連微通道填充���,可以有效控制互連微通道的形貌���,以有效解決高密度互連中的散熱問題。并通過綜合性減薄技術(shù)���,有效實(shí)現(xiàn)超薄 TSV 轉(zhuǎn)接板的加工�,解決在 TSV 三維封裝中減薄工藝容易裂片的問題����,實(shí)現(xiàn) TSV 三維封裝的產(chǎn)業(yè)化開拓了道路。 |

采用半導(dǎo)體工藝�����, 加工具有高的深寬比微納米孔����。 |

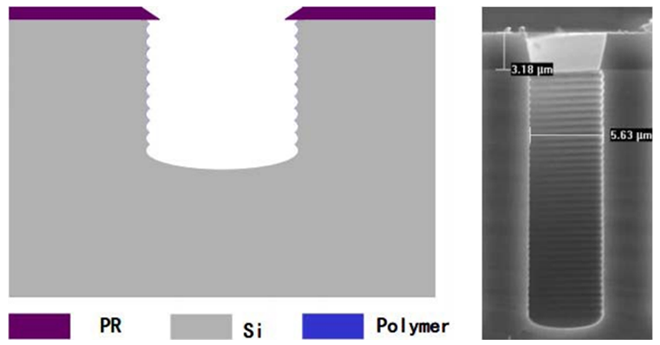

硅通孔技術(shù)可以通過垂直互連減小互聯(lián)長(zhǎng)度,減小信號(hào)延遲�����,降低電容/電感,實(shí)現(xiàn)芯片間的低功耗�����,高速通訊���,增加寬帶和實(shí)現(xiàn)器件集成的小型化���。 廣泛應(yīng)用于射頻���、存儲(chǔ)��、通訊等芯片的三維封裝領(lǐng)域�����。 |


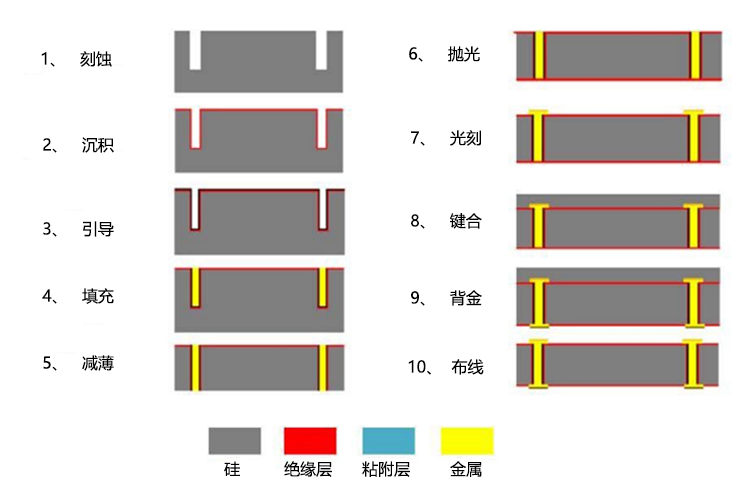



劉經(jīng)理:18913756333(微信同號(hào))